DBG/グライディング
DBG加工
『驚異的な仕上がり・高品質、薄型ICチップ!!』加工で超薄型チップ加工が簡易的に!!
DBG加工とは?(Dicing Before Grinding)
従来の薄厚基板の個片化(チップ化)は、バックグラインディング → ダイシングというフローが一般的な加工方法ですが、 先にウエハへ、ハーフカットダイシングを施し(スクライブ上溝入れ)その後、バックグラインディング(裏面研削)する事によりチップへ分割するプロセスです。従来のダイシング加工と比べ裏面チッピングの大きさを軽減させることが可能です。

従来

DBG加工
DBG加工プロセス
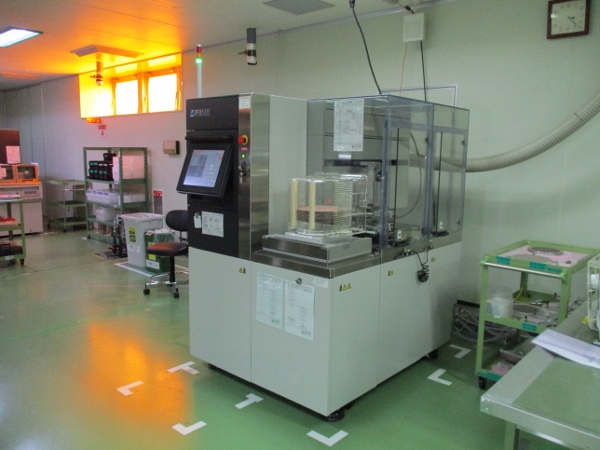
DFD6361 ハーフカット仕様

RAD3510F/12
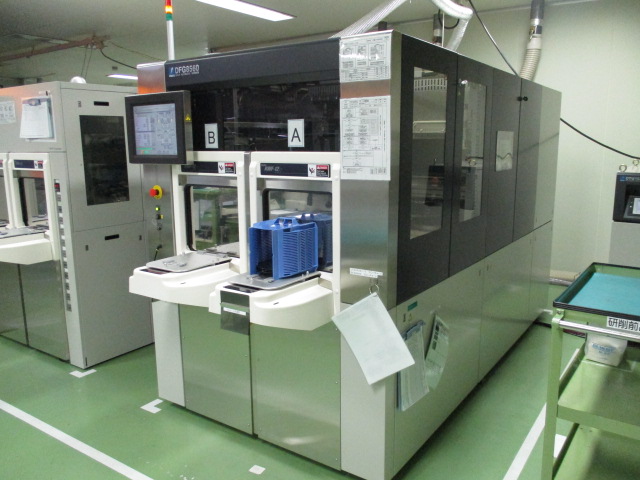
DFG8560
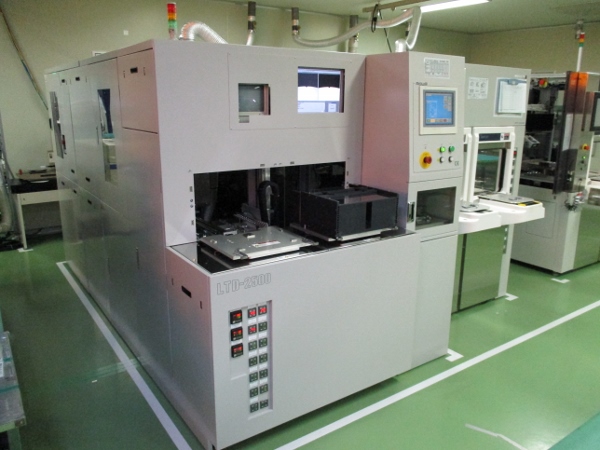
LTD2500F/12
| 対応サイズ | チップサイズ | 仕上厚 | 表面AL/ インク付 |
表面 半田Bump |
表面 金Bump |
各種表面膜 | リング 出荷形態 |
備考 |
|---|---|---|---|---|---|---|---|---|
| 6inch | □0.30mm~ 短冊系0.3*8.0~ |
0.020mm~適宜 | ○ | ○ | ○ | ○ | 6-12インチフレーム | ご要望により、 トレイ詰めまで |
| 8inch | ○ | ○ | ○ | ○ | 8-12インチフレーム | |||
| 12inch | ○ | ○ | ○ | ○ | 12インチフレーム |
バックグラインディング(研削加工)
表面バンプ成形品からリジェクトインク付ウエハ―まで、様々な表面コンディションに適用しバックグラインディング(裏面研削)を行います。お客様のニーズに合わせた仕上げ厚みをご提供します。仕上げ砥石#2000 #6000 #8000をご用意しております。
対象:シリコン(他材質は別途検討致します)尚、形状はといません
バックグラインディング プロセス(研削プロセス)

| 対応サイズ | 仕上厚 | 表面AL/インク付 | 表面 半田Bump |
表面 金Bump |
各種表面膜 | 円形状以外 の研削 |
面粗さ ※参考 |
砥石番手 |
|---|---|---|---|---|---|---|---|---|
| 4inch | 要検討(一部マニュアルにて対応可) | チップ研削、他 | 0.06mm~ 0.015um (Ra) |
#360 #2000 #6000 #8000 ※その他 ご要望に応じて |
||||
| 5inch | 0.020mm ~ |
○ | ○ | ○ | ○ | |||
| 6inch | ○ | ○ | ○ | ○ | ||||
| 8inch | 0.030mm ~ |
○ | ○ | ○ | ○ | |||
| 12inch | ○ | ○ | ○ | ○ | ||||
厚み測定機(自社開発:分解能 1/10000mm)
※測定結果を電子化
EBG工法
弊社保有のDBG工法を応用した新たな工法
Etching Before Grinding
E・・・Etching(エッチング)
B・・・Before
G・・・Grinding(研削)

エッチング



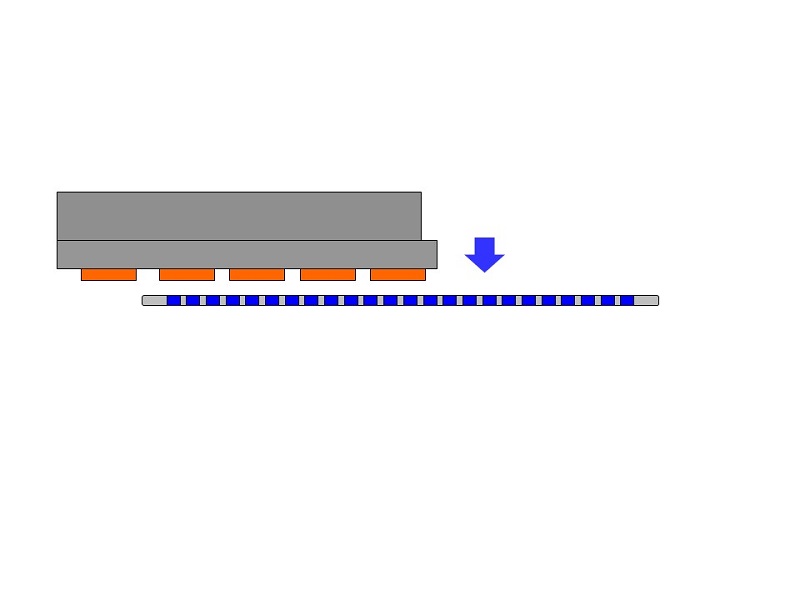
バックグラインディング

エッチングの状態
(協力工場による)


顕在化の状態
シリコンは・・・
磁力の影響を受けず腐食や摩耗への優れた耐性を持ち
「鋼鉄よりも硬くて軽い」
「温度変化による影響を受けない」
これらの利点を活かした部品を製作してみませんか・・・!
お問合せからの流れ(特殊)

